
 捷克泰思肯 TESCAN SOLARIS 新一代超高分辨鎵離子FIB-SEM
捷克泰思肯 TESCAN SOLARIS 新一代超高分辨鎵離子FIB-SEM
 捷克泰思肯 TESCAN AMBER 鎵離子型雙束掃描電鏡
捷克泰思肯 TESCAN AMBER 鎵離子型雙束掃描電鏡
 捷克泰思肯 TESCAN SOLARIS X 氙等離子源雙束FIB系統
捷克泰思肯 TESCAN SOLARIS X 氙等離子源雙束FIB系統
 捷克泰思肯 TESCAN AMBER X 高分辨氙離子源雙束掃描電鏡
捷克泰思肯 TESCAN AMBER X 高分辨氙離子源雙束掃描電鏡
 TESCAN 電鏡質譜 FIB-SEM-TOF-SIMS 聯用系統
TESCAN 電鏡質譜 FIB-SEM-TOF-SIMS 聯用系統
產品介紹:
TESCAN SOLARIS X 是一款氙(Xe)等離子超高分辨雙束 FIB-SEM 系統,配置新穎的 TriglavTM 超高分辨率電子鏡筒以及zui新款的 iFIB+TM 離子鏡筒,它的超高分辨表征能力和無與倫比的樣品制備效率,非常適合于材料、生命及半導體領域分析表征中zui具挑戰性的大體積三維樣品的分析工作。
TESCAN SOLARIS X 配置的 TriglavTM 超高分辨率電子鏡筒,同時使用了全新的 TriLensTM 三透鏡系統以及gao效的 TriSETM 和 TriBETM 探測器系統,能夠提供zhuo越的表面靈敏度和襯度圖像,實現對電子束高敏材料或不導電材料納米特征的觀察。
TESCAN SOLARIS X 是半導體和材料表征中zui具挑戰性的物理失效分析應用的平臺,具有極高的精度和極高的效率。 它不但提供了納米尺寸結構分析所必需的高分辨率和表面靈敏度,為大體積 3D 樣品特性分析保證zui佳條件。同時,它還提供非凡的 FIB 功能,可實現精確、無損的超大面積加工,包括封裝技術和光電器件的橫截面加工。
TESCAN SOLARIS X Xe Plasma FIB-SEM 主要優勢:
突出特點
新型 iFIB+? Xe 等離子 FIB 鏡筒可提供高達 2 μA 的超高離子束束流,并保持束斑質量,從而縮短銑削任務的總時間。
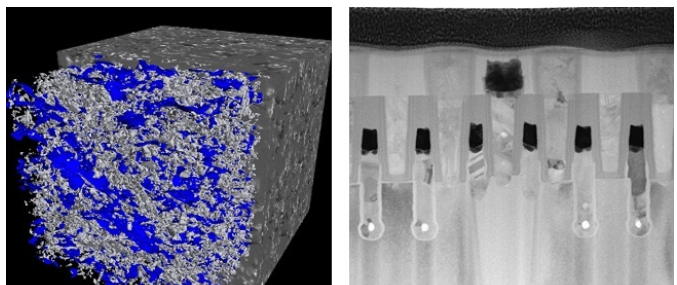
圖(左):SiAlON - 石墨烯樣品的三維重構圖像,使用 In-Beam f-BSE 探測器逐層成像,該樣品的 FIB-SEM 層析成像由 1339 層組成,重構的尺寸為 22×22.3×66.9 μm。
圖(右):使用 Xe 等離子體 FIB 從 DRAM 65 nm節點上制備出的 80 nm 厚度的 TEM 樣品,STEM-BF 高倍圖像。
* 新型 iFIB+? Xe 等離子 FIB 鏡筒具有無與倫比的視野,可實現極大面積的截面加工
新型 iFIB 鏡筒具有等離子 FIB-SEM 市場中zui大的視場(FoV)。在30 keV 下zui大視場范圍超過 1 mm,結合高離子束流帶來的超高濺射速率,可在幾個小時之內完成截面寬度達 1 mm 的電子封裝技術和其他大體積(如 MEMS 和顯示器)樣品加工。這是簡化復雜物理失效分析工作流程的zui佳解決方案。
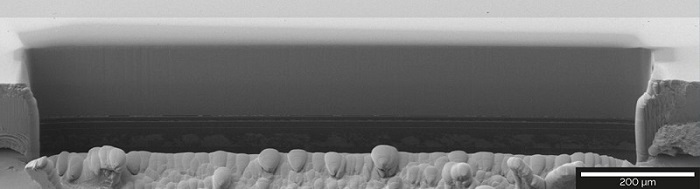
圖:OLED 顯示屏,橫截面長度為 1086 μm,視野范圍 1.26 mm
新型 iFIB+? Xe 等離子 FIB 離子束流強度可調范圍大,可在一臺機器中實現廣泛的應用:大電流可實現快速銑削速率,適用于大體積樣品去層;中等電流適用于大體積 FIB 斷層掃描;低束流用于 TEM 薄片拋光;超低束流用于無損拋光和納米加工。
快速、gao效、高性能的氣體注入系統(GIS)對于所有 FIB 應用都是必不可少的。新的 OptiGIS? 具有所有這些品質,TESCAN SOLARIS X 可以配備多達 6 個 OptiGIS 單元,或者可選配一個在線多噴嘴 5-GIS 系統。此外,不同的專有氣體化學品和經過驗證的配方可用于封裝技術的物理失效分析。
新型 iFIB+ 鏡筒配有超穩定的高壓電源和精確的壓電驅動光闌,可在 FIB 預設值之間快速切換。此外,半自動束斑優化向導允許用戶輕松選擇zui佳束斑,以優化特定應用的 FIB 銑削條件。
與 Ga 離子相比,Xe 離子的離子注入范圍和相互作用體積明顯更小,因此帶來的非晶化損傷也更小,這在制備 TEM 樣品薄片時尤其重要。此外,Xe 離子的惰性特性可防止研磨樣品的原子形成金屬化合物,這可能導致樣品物理性質的變化,從而干擾電測量或其它分析。
由 TriSE? 和 TriBE? 組成的多探測器系統,可收集不同角度的 SE 和 BSE 信號,以獲得樣品的zui大信息。
新一代 Triglav? 鏡筒內探測器系統經過優化,信號檢測效率提高了三倍。此外,增加的能量過濾功能,可以對軸向 BSE 信號過濾采集。通過選擇性地收集低能量軸向 BSE,實現用不同的襯度來增強表面靈敏度。
鏡筒內探測器系統可實現快速圖像采集,結合 Xe 等離子體 FIB 的高濺射速率,可實現 3D 微量分析的超快速數據采集。EDS 和 EBSD 數據可以在 FIB-SEM 斷層掃描期間同時獲得。使用專用軟件進行后處理,可以獲得 3D 重建,實現整個焊球、TSV、金屬合金等樣品的獨特微觀結構,成分和晶體學信息。
新一代 Triglav? 還具有自適應束斑優化功能,可提高大束流下的分辨率。這有利于快速實現 EDS,WDS 和 EBSD 等分析技術。
Triglav? SEM 鏡筒結合新型肖特基 FE 槍,可實現高達 400 nA 的電子束流,并實現束流快速調整。In-Flight Beam Tracing? 功能可以實現束流和束斑優化,滿足微區分析的zui佳條件。
得益于zui佳的 60° 物鏡的幾何設計和大樣品腔室,可實現對 6“ 和 8”晶圓任意位置的 SEM 和 FIB 分析。
新的 TESCAN Essence? 軟件平臺是一個優秀的多用戶界面軟件,可以快速方便地訪問主要功能。用戶界面易于學習,并可實現用戶定制,以zui好地適應特定的應用程序和用戶的技能水平以及使用習慣。各種軟件模塊,向導和流程使所有 FIB-SEM 應用程序都能為新手和專家用戶提供輕松,流暢的體驗,從而提高生產力并有助于提高實驗室的效率。新的 TESCAN Essence? 還提供先進的 DrawBeam? 矢量掃描發生器,用于快速精確的 FIB 加工和電子束光刻。

* TESCAN SOLARIS X 是 S9000X 的升級機型。












報價:面議
已咨詢4501次聚焦離子束顯微鏡

報價:面議
已咨詢4378次聚焦離子束顯微鏡

報價:¥10000000
已咨詢241次FIB 聚焦離子束顯微鏡

報價:面議
已咨詢4761次聚焦離子束顯微鏡

報價:面議
已咨詢6965次掃描電鏡/掃描電子顯微鏡

報價:面議
已咨詢5007次掃描電鏡/掃描電子顯微鏡

報價:¥8000000
已咨詢264次FIB 聚焦離子束顯微鏡

報價:¥10000
已咨詢770次雙束聚焦掃描電鏡FIB-SEM

SU3900/SU3800 SE系列作為FE-SEM產品,配置超高分辨率與觀察能力。此系列突破了傳統SEM產品受安裝樣品尺寸與重量的限制,通過簡單的操作即可實現數據采集。可用于鋼鐵等工業材料,汽車、航空航天部件等超大、超重樣品的觀察。 此外,SE系列包括4種型號(兩種類型,兩個等級),滿足眾多領域的測試需求。用戶可以根據實際用途(如微觀結構控制:用于改善電子元件、半導體等材料的功能和性能;異物、缺陷分析:用于提高產品品質)選擇適合的產品。




1波長范圍:400 - 1000 nm 2每一像素同時檢測時間(ToA)和強度(ToT)3時間分辨率1.6 ns,有效幀速率> 500 MHz 4無損、數據驅動讀出速度高達80 Mhits / s

高性能電子光學系統 二次電子分辨率: 頂位二次電子探測器(2.0 nm at 1kV)* 高靈敏度: 高效PD-BSD, 超強的低加速電壓性能,低至100 V成像 大束流(>200 nA): 便于高效微區分析 性能優異 壓力可變: 具有優異的低真空(10 -300 Pa)成像性能,配備高靈敏度低真空探測器(UVD)* 開倉室快速簡單換樣(Z大樣品尺寸: Φ 200 mm x 80 mmH) 微區分析: EDS, WDS, EBSD等等


ParticleX TC 全自動汽車清潔度分析系統 取代傳統顆粒物清潔度檢測方法,允許工程師看見微米尺寸的顆粒并確定其化學成分,從而判斷出污染源。